物理・表面計測系
集束イオンビーム加工観察装置(FIB)
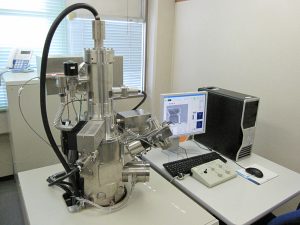
| メーカー | 日本電子 |
|---|---|
| 型番(形式) | JEM-9320FIB |
| 設置場所 | 22号館414室 |
| 管理室 | 電子顕微鏡試料作成室 |
| 公開範囲 | 学内外 |
| 技術職員 | 配置あり |
| 学内利用 | 機器分析受付システム |
本装置は2024年度内に廃棄予定です。複合ビーム加工観察装置(FIB-SEM)をご利用ください。
透過電子顕微鏡観察のために、試料から10μm×10μm×100nm程度の薄片を切り出すための装置です。加工後、大気下で光学顕微鏡を利用したピックアップシステムで試料をTEMメッシュに移しかえます。
装置性能および仕様
| イオン銃 | ガリウム液体金属源 |
|---|---|
| 加速電圧 | 5~30kV(5kVステップ) |
| 加工形状 | 矩形、ライン、スポット |
分析対象
| 状態 | 非導電性試料は金属蒸着などで導電性にしてください |
|---|---|
| 試料サイズ | 縦、横サイズはφ10mm以内かつ高さ1mm程度 |
| 加工不可 | ガリウムが試料内に残るのでガリウムを含む試料の元素分析には向きません |
加工例
非導電性のSiO2は導電性処理を施したのちFIB加工をしなければなりませんが、金属(Pt)スパッタを施すと、SiO2の最表面(SiO2とPtの間)数nmはスパッタのダメージを受けてしまいます。名工大ではこれを回避する独自の処理を開発しており、鮮明な表面TEM観察像を得ることができます。